把握半导体大周期工控自动化助力提升设备国产化率
 半导体设备.png" style="margin: 0px auto; width: 400px;" alt="半导体设备.png" width="400" height="" border="0" vspace="0">
半导体设备.png" style="margin: 0px auto; width: 400px;" alt="半导体设备.png" width="400" height="" border="0" vspace="0">
随着拜登政府延续并扩大了中美贸易摩擦以来的半导体政策,导致潜在的设备供应压力和风险逐步加大,加上在国内晶圆厂产能不断扩张的同时,也在持续导入国产设备,扶持本土战略供应商,这些使得国产半导体设备进入到一个难得的发展大周期,国产化率的提升,为了工控自动化行业提供了一条潜力无穷的优质赛道。
? 今年7月30日,在对中国企业进行制造10纳米及以下芯片设备禁运的基础上, 美国限制出口的范围扩大到制造14纳米及以下芯片的设备;
8月9日,美国总统签署《2022芯片与科技法案》, 向半导体行业提供约527亿美元的资金支持,为企业提供价值240亿美元的投资税抵免,鼓励企业在美国研发和制造芯片, 并限制美国企业支持中国等国家的半导体研发和生产;
8 月12 日,美国商务部工业和安全局(BIS)发布公告, 将四项“ 新兴和基础技术” 纳入新的出口管制, 其中有半导体材料氧化镓和金刚石,及专门用于3纳米及以下芯片设计的EDA/ECAD软件等;
8月下旬,据台媒报道,美国近期发起芯片四方联盟( Chip 4),意欲与中国台湾、日本与韩国共同推动半导体出口、技术外流等管制,形成反对中国大陆的联盟......
面对日益紧迫的国际政经环境,中国政府要实现中高端芯片完全国产化的决心更加坚定, 中国本土半导体产业在困难与机遇中继续前行,并已势不可挡。
半导体设备开发难在哪里
俗话说:巧妇难为无米之炊,要烧出一锅好菜,好的厨具和食材缺一不可。半导体制造设备和材料在产业链中就相当于“ 厨具” 和“ 食材” 的角色, 特别是从目前情况来看, 美国主要是通过卡设备、原材料的进口进行降维打击, 使设备和原材料成为制约国内半导体生产工艺发展的“瓶颈”。

图 1 主要零部件产品及其主要服务的半导体设备
(来源:网络信息整理)
? ? ? ? 众所周知,半导体设备、材料的投资开发周期长, 投入资本大, 更关键的是涉及到基础学科的培养, 平心而论, 现阶段的中国半导体装备行业要想从无到有, 从有发展到世界领先水平,确实还有很长的一段路要走。
在制造业中,每一台设备都是由大大小小不同类型的零部件所组成, 半导体属于微精密机械加工领域, 其中涉及到的各种零部件都是世界尖端高精密级别。有专业人士统计过, 目前在半导体设备制造过程中, 中国在很多零部件细分领域尚无法实现自给自足, 例如: 密封圈、微型气缸、电工开关、阀门、质量流量计气体检测仪器等, 仍以日本、欧美品牌为主; 还有光纤传感器、微型步进电机、伺服电机等零部件方面, 国产品的使用率仍然很低。对于现阶段中国半导体设备的开发而言, 主要的难题之一在于高精密产业供应链的不齐全, 究其缘由,里面既有技术因素,也有经济因素。
中国半导体产业发展正经历一个大周期、持续追赶的过程, 对于资本的要求也会越来越高。只有首先把微小精密加工零配件产业链做起来, 加上在半导体主设备里的传输系统、净化真空系统、主体工艺系统、循环排放系统等领域实现更高水平的自动化、智能化, 协助将晶圆制造的良品率达到更高的等级, 这样才有可能真正做到中国半导体制造全流程的自主可控。
为此,2006年,中国政府出台了“十六个重大科技专项”,其中,《极大规模集成电路制造装备及成套工艺》项目排在第二位,因此也被简称为“0 2 专项”。同时,国家大基金一期投资约1400亿元(2014- 2019)、国家大基金二期投资约2000亿元(2017-2019),从集成电路芯片制造业、芯片设计、封装测试设备和材料等产业( 一期侧重点), 以及应用端, 例如下游的5G、AI、Io T等技术引领的集成电路应用产业( 二期侧重点) 等重点面向, 全力推进中国本土半导体产业的高速发展。
国产半导体设备:由0至1的跨越
根据国际半导体产业协会(SEMI)的统计数据显示,2021 年半导体设备销售额 1026 亿美元,同比激增 44% ( 见图2), 全年销售额创历史新高。中国大陆设备市场在 2013 年之前占全球比重为 10 %以内, 2014~ 2017年提升至 10~ 20%,2018年之后保持在20% 以上,份额呈逐年上行趋势。2020~2021年,国内晶圆厂投建、半导体行业加大投入, 大陆半导体设备市场规模首次在市场全球排首位,2021达到 296.2亿美元,同比增长 58%,占比达28.9%(见图3)。

图 2 全球半导体设备销售额及增速
(资料来源:SEMI)

图 3 中国半导体市场规模及在全球市场占比
(资料来源:SEMI)
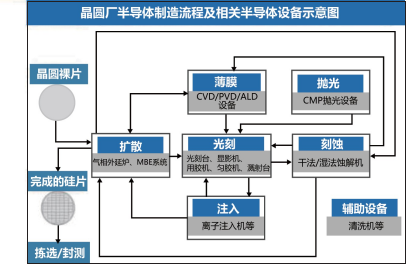
图 4 晶圆厂半导体制造流程及相关设备图
(资料来源:《半导体制造技术》)
从国家02专项、以及国家集成电路产业基金一期、二期的进展情况来看, 当前, 中芯国际、长鑫存储、华虹集团、长江存储等国内主流晶圆厂已成为扩产的主力军, 多个新厂区项目将继续拉动本土半导体设备的市场需求。
在半导体制造的各个工艺环节上,薄膜沉积、光刻、刻蚀是总价值最高的三大半导体设备(见图4),其中, 光刻和薄膜沉积是目前国产化率较低的设备种类。另外, 涂胶显影、离子注入、过程控制也是国产化率比较低的设备类型;而刻蚀、氧化扩散/热处理、清洗、去胶、化学机械抛光则是国产设备发展得较好的领域( 国产化率均可达到20%以上)。经过近几年的市场培育, 以北方华创、中微公司、盛美上海、拓荆科技、中科飞测、屹唐股份等为代表的一批优秀的本土半导体设备厂商不断涌现,加速国产化替代的进程。
另一方面,根据02专项当年的规划,目标是“形成65 -45 nm装备、材料、工艺配套能力及集成电路制造产业链,进行45- 22nm关键制造装备攻关, 同时开展22- 14nm前瞻性研究等等”;对照这一目标,目前在45-22nm工艺,除了光刻机之外,已基本上实现了国产替代,也有消息称,上海微电子的28nm光刻机预计将在明年完成交付, 可见整个国产替代的节奏正在加快, 对于整体产业链来说, 半导体设备市场的产能扩展叠加国产替代的大趋势, 为各个相关产品线行业提供了一个良好的发展机遇。
直驱技术:超精密对准与定位功能
大致上,半导体制造工业流程可分为三大板块,
即: 硅片生长、晶圆制造和封装测试, 硅片生长是将硅材料加工成硅片的过程, 这个过程中, 从拉单晶、到晶棒加工、切片、研磨、倒角, 再到抛光。半导体制造的前道工艺主要指的是晶圆制造厂的加工过程, 在空白的硅片完成电路的加工,出厂产品依然是完整的圆形硅片。在晶圆制造过程中, 通过热处理、薄膜沉积、涂光刻胶、曝光、显影、刻蚀等一系列步骤的循环往复, 形成有电路结构的硅片。而半导体制造的后道工艺则指的是封测环节, 即封装和测试过程, 在封测厂中将圆形的硅片切割成单独的芯片颗粒, 完成外壳的封装, 最后通过终端测试,出厂即为半导体芯片成品。
目前,半导体封测是工控自动化厂商开发的热点市场之一, 以直驱技术领域为例, 超精密直线电机运动平台凭借优异的对准、定位性能, 在晶圆切割、晶圆检测和成品测试探针台等相关设备上得到了广泛的应用。
深圳市克洛诺斯科技有限公司以纳米级、微米级直线电机运动平台的研发、生产为主, 其推出的纳米级精密平台由压力- 真空空气轴承和超高精密编码器设计,最大可对应300mm晶圆,编码器位置靠近基板表面,减少已经最小的偏移影响, 移动模块和十字导轨采用陶瓷
(Al203)设计,比花岗岩或金属设计刚性好,重量轻, 热膨胀系数低, 以及应用激光干涉仪反馈系统; 下轴由2个水冷式无铁芯直线电机组成, 靠近系统的重心, 采用龙门方式控制, 上轴由单个水冷式无铁芯直线电机组成, 可以是集成的T平台或Z T平台或Z T4D平台, 即4个自由度模块用于对准, 该纳米级精密平台可应用于晶圆检测、晶圆切割等典型的半导体制造场景。另外, 克洛诺斯自主研发的超精密纳米级气浮平台是定位晶圆或芯片的核心部件,重复定位精度可达到±35 纳米,适应用于晶圆切割、晶圆检测、晶圆封装等工艺环节。
为了满足晶圆切片应用中准确定位切口、减少材料损耗、尽可能减小元件变形、同时又必须达到最大加工速度等要求,PI(Physik Instrumente)普爱纳米位移技术(上海)有限公司开发的运动解决方案在Z轴采用高动态激光聚焦控制( P- 725 PIFOC物镜扫描仪), 可实现高达800微米的行程,与晶圆厚度相匹配,以及亚纳米级分辨率的精密定位功能; θ X/ θ Y/ Z轴采用高精度晶圆对准和定位( A- 523 Z向偏摆台),以并联运动设计, 可实现三个维度的晶圆调整和偏移校正, 带空气轴承的直接驱动线性电机可实现高精度调平, 具有最小滞后的无摩擦设计, 提供了纳米级的高重复精度和可调整性; XY轴则运用高动态晶圆扫描运动( A- 311空气轴承平面扫描仪), 配以先进的自动化控制系统, 令到半导体晶圆切割的良率更高, 可实现无污染加工, 形成狭窄的通道宽度, 不会损坏前后表面, 且具备高性能处理能力,完全沿预定义的切割线高动态形成均匀的层调制。
驱控技术:高精度、高速度、高性能
在封装测试环节,基于芯片封装技术微型化和集成化的快速发展, 划片机、固晶机、分选机, 作为芯片封装测试过程中的三大关键设备, 对企业管控芯片的生产效率和良品率具有重要的作用, 并且朝着高精度、高速度、高性能的方向迈进。
例如在半导体制作工序持续微缩的过程中,晶圆切割的精准度尤为关键, 在晶圆的激光切割技术上, 目前面临的挑战包括: 精准度不佳、运动轨迹在高精度不易达到、激光功率不易调整、速度规划旷日费时等。
针对上述激光切割技术难题,高创传动科技开发(深圳)有限公司提出了sof tMC 301 控制器作为晶圆切割运动控制理想解决方案,sof tMC 301 支持两种开放、整合的开发环境:Codesys或ControlStudio,用户可通过程序辅助, 提升性能并简化操作。该控制器内置高实时Linux操作系统,支持EtherCAT或CANOpen 现场总线,可控制最多6个轴,能够在切割过程中维持马达的稳定, 解决以往激光切割机台过切、抖动和速度规划不易等问题。
另外,芯片拾取与贴装是高密度、超薄芯片封装技术的两项关键工艺, 芯片拾取与贴装的效率和可靠性直接影响着电子封装的进程、生产率和成本。选择高精度的运动控制伺服方案驱动部件能以精确的力度拾取芯片, 并安全、准确地转移到基板上, 这是提升超薄芯片封装效率的一大关键。
目前高创根据客户的应用需求,可为客户量身定制运动控制综合解决方案包括:划片机CDHD2伺服方案、分选机BDHDE伺服方案、固晶机CDHD伺服方案等多个定制化技术方案。
在半导体芯片后道工序中,划片机以强力磨削为划切机理, 空气静压电主轴为执行元件, 以每分钟3万到6万的转速划切晶圆, 同时承载着晶圆的工作台以一定的速度沿刀片与晶圆接触点的划切线方向做直线运动, 将每一个具有独立电气的芯片分割出来。基于划切工艺的复杂性,客户对划片机各轴的划切运动控制性能提出更高的要求,为此,高创提供的伺服方案——X轴应用CDHD驱动器+ PH2电机,Y 轴应用CDHD2驱动器+ PH 2 电机, 旋转轴采用CDHD驱动器+DDR马达,三轴联动使划片机实现快速、稳定、精准的划切和清洗运动。分选是芯片封装过程中的一个重要步骤,而分选机则是用于芯片测试接触、拣选和传送的设备,能够辅助提高芯片分选的效率和质量。在芯片设计日益复杂化、精细化、多样化的趋势下, 其对驱控产品的精度、速度、稳定性要求也越来越高,高创BDHDE驱动器+CDHD驱动器+PRHD2 电机组成的伺服方案,可助力提升分选机送料、夹料、落料、传送、拣选的速度, 提高芯片智能检测、智能分选的效率、精度与质量。
结语
面对全球经济下行周期,消费类电子市场需求严重萎缩, 企业库存处在历史较高水平, 半导体产业进入到调整期; 而另一方面, 在诸多外部因素的刺激下, 中国大陆仍将是未来全球芯片制造扩产的重点区域, 据不完全统计, 仅华虹集团、中芯国际、长江存储、合肥长鑫四家晶圆厂的未来合计扩产产能就将超过100万片/月。在中国半导体开启新的征程之际, 半导体设备的本地化供应链建设迫在眉睫, 中国半导体制造设备的国产化进程, 无论是对于国际品牌、还是本土品牌供应商来说, 都是一片广阔的开发天地。除了现阶段较多工控自动化厂商已经涉及到的芯片后道封装测试领域之外, 还有更多价值较高的半导体工艺环节值得期待, 工控厂商应与设备原厂携手合作, 发挥协同效应, 为中国半导体产业迈向高端制造贡献行业力量。
